[GTC 2026]삼성 파운드리, 차세대 AI칩 그록3 생산..HBM·로직·패키징의 유기적 결합 강점

"삼성이 세계 최고다! 그건 내가 인정할 수밖에 없다.(Samsung is world's best! I should approve that.)"
16일(현지시간) 'GTC 2026' 기조연설을 마친 젠슨 황 엔비디아 최고경영자(CEO)가 삼성전자(220,500원 ▼5,500 -2.43%) 부스를 찾아 한 말이다. 황 CEO는 이날 삼성전자 메모리사업부가 개발한 6세대 고대역폭메모리(HBM4) 반도체 등 메모리 설루션이 들어간 엔비디아의 인공지능(AI) 칩 '베라 루빈 플랫폼', 삼성 파운드리사업부에서 생산한 '그록3(Groq3)' 칩과 4나노 공정 기반 웨이퍼까지 4개 제품에 사인을 남겼다.
1년 전만 해도 삼성전자가 HBM3E(5세대) 공급에 어려움을 겪으면서 황 CEO가 지난해 GTC에서 삼성 GDDR(그래픽 D램)7 제품에 사인을 했던 모습을 떠올리면 삼성의 절치부심이 만들어낸 극적인 반전이다. 메모리와 파운드리(위탁생산), 패키징을 아우르는 종합반도체기업(IDM)으로 AI 반도체 경쟁력을 보여주는 상징적인 장면으로 평가된다.
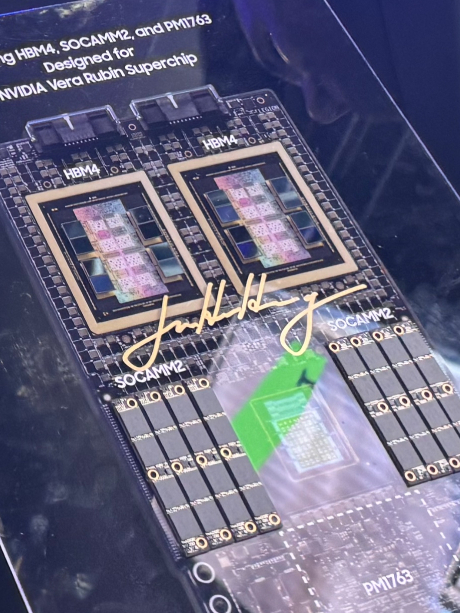
이날 미국 캘리포니아 새너제이 SAP센터에서 진행된 황 CEO의 기조연설에서 관객들의 시선은 추론에 특화된 AI LPU(Language Processing Unit) 칩 '그록3'에 쏠렸다. 황 CEO는 "삼성이 엔비디아를 위해 '그록3 LPU' 칩을 제조하고 있다"며 "감사의 뜻을 전하고 싶다"고 밝혔다.
그록3는 추론 전용 랙 아키텍처인 '엔비디아 그록3 LPX'에 탑재된다. LPX 1대에는 256개의 그록3 칩이 들어간다. LPX는 베라 루빈 플랫폼과 결합해 전력·메모리·컴퓨팅 전반의 효율성을 높이는 역할을 한다. 메가와트(MW)당 최대 35배 높은 추론 작업을 처리할 수 있다.
삼성 파운드리는 올해 3분기 그록3를 출하할 계획이다. 한진만 삼성전자 파운드리사업부장(사장)은 "현재 평택사업장에서 4나노(nm·1nm는 10억분의 1m) 공정으로 그록3를 생산하고 있다"며 "올해 예상했던 것보다 많은 주문이 들어왔다"고 설명했다. 이어 "삼성 HBM4의 베이스 다이(웨이퍼)도 4나노 공정으로 생산하고 있어 앞으로 4나노 수요가 크게 늘어날 것"이라고 말했다. 그록3 매출은 내년부터 본격적으로 반영될 것으로 보인다.
분기마다 1조~2조원대 적자를 기록하며 '아픈 손가락'으로 불렸던 파운드리 사업의 가동률도 빠르게 회복되는 분위기다. 업계에서는 내년 파운드리 사업이 적자에서 벗어날 가능성도 제기된다. 삼성 파운드리는 현재 4나노 공정으로 그록3와 HBM4 베이스 다이를 생산하고 있고 향후 2나노 공정으로 현재 개발 중인 HBM5를 비롯해 테슬라 AI 칩과 엑시노스 시리즈를 생산할 예정이다.

삼성 파운드리가 GTC에서 새로운 가능성을 보여줬다면 메모리사업부는 세계 1위의 위상을 다시 한번 부각시켰다. 삼성전자는 전시부스에 'HBM4 히어로 월(Hero Wall)'을 마련하고 HBM 기술 리더십을 전면에 내세웠다. 엔비디아의 차세대 AI 시스템인 '베라 루빈' 플랫폼에 메모리와 저장장치를 모두 공급하는 유일한 기업이라는 점을 재확인하고 나선 것이다.
독자들의 PICK!
이날 세계 최초로 공개한 HBM4E도 눈길을 끌었다. 삼성전자의 메모리와 파운드리, 로직 설계, 첨단 패키징 기술을 결합해 핀당 최대 초당 16Gb(기가비트) 속도와 최대 초당 4.0TB(테라바이트) 대역폭을 지원하도록 설계된 제품이다.
황상준 삼성전자 메모리개발담당 부사장은 "HBM4E에 맞춰 베이스 다이에 해당하는 4나노 파운드리 트랜지스터 성능이 개선됐다"고 전제한 뒤 "초당 16Gb 속도로 동작하지만 이전 세대와 동일한 수준의 전력을 사용한다"며 "HBM5E의 경우 코어 다이는 1d(10나노급 7세대) 공정을, 베이스 다이는 삼성 파운드리 2나노 공정을 사용할 것"이라고 말했다.
삼성전자는 HBM4 외에 '베라 CPU(중앙처리장치)'용 저전력 메모리 모듈 'SOCAMM2(소캠2)'와 초고속 저장장치 PM1763을 함께 전시했다. HBM 성능을 획기적으로 끌어올리면서도 발열 문제를 해결할 수 있는 차세대 패키징 기술도 공개했다. 삼성전자의 HCB 기술은 구리를 이용해 칩을 직접 연결, 기존 TCB(열과 압력을 이용해 반도체 칩을 접합하는 패키징 기술) 방식보다 열 저항을 20% 이상 개선하면서 16단 이상 고적층을 지원할 수 있는 기술로 평가받는다.
삼성전자는 메모리·로직·첨단 패키징 설루션을 한번에 제공할 수 있는 세계에서 사실상 유일한 종합반도체기업으로 글로벌 AI 리더십을 강화해나간다는 전략이다. 한 사장은 "삼성은 파운드리와 메모리를 동시에 보유하고 있어 새로운 AI 설루션에 대한 대응 속도가 빠르다"며 "여러 과제가 동시에 진행되고 있고 메모리와 로직이 결합된 설루션을 지속적으로 연구하고 있다"고 덧붙였다.


