[반준환의 미국 스몰캡] 냉각인프라 업체들
마이크론 '보텀사이드 쿨링 기술' 보유, 히트슬러그 개발 땐 시너지
파커하니핀, 열 분산 핵심소재 'TIM' 공급… 포트폴리오 확장해 경쟁력 ↑
버티브, 엔비디아의 공식 냉각 파트너… S&P500 편입, 주류 자리매김
모다인, AI데이터센터 특화 냉각 장비… 매출 급성장, 新주도주로 부상
엔비디아의 칩 같은 AI(인공지능) 가속기(GPU)는 챗GPT 같은 AI 에이전트를 똑똑하게 훈련시키기 위해 한 번에 어마어마한 양의 수학 계산을 해야 한다. 계산결과를 빛의 속도로 저장하고 다시 읽어와야 하는데 이때 중요한 게 메모리칩의 성능이다. GPU(그래픽처리장치)가 아무리 빨라도 데이터를 제공하는 메모리가 늦는다면 GPU가 일을 멈추고 놀게 된다. GPU가 늘어날 때 메모리반도체의 수요가 기하급수적으로 더 증가하는 이유다.
엔비디아의 GPU에 걸맞은 메모리반도체는 HBM(고대역폭메모리)이다. D램 같은 기존 메모리반도체를 1차선 국도로 치면 HBM은 수백 대의 차가 동시에 내달릴 수 있는 1024차선 아우토반에 비유된다. D램을 아파트처럼 위로 쌓은 뒤 구멍을 뚫어 수직으로 연결했기 때문에 데이터가 이동하는 통로(대역폭)가 넓다.
물리적으로 메모리칩은 GPU와 한 몸처럼 붙어 있어야 제 성능을 낼 수 있다. 고3 수험생에게 집과 학원의 거리나 마찬가지다. 1나노(㎚·1㎚는 10억분의1m) 거리가 엄청난 차이를 불러온다.
◇GPU+HBM 패키징, 현재는 2.5D→3D 개발에 사활 건 반도체업계
처음에는 인텔의 MCM처럼 CPU(중앙처리장치)와 메모리칩 몇 개를 한 패키지에 넣되 모두 같은 높이의 평면에 나란히 놓는 2D(차원) 방식이었다.
이후 2.5D라 불리는 인터포저(Interposer)가 등장했다. 이는 GPU와 HBM이 올라앉는 작은 실리콘 받침대인데 보통 가로세로 80~100㎜ 정도의 얇은 실리콘 판이다. 이 판 안에 수만 개의 미세한 구리 배선이 새겨져 있다. 칩보다 훨씬 얇고 미세한 배선이다.
GPU와 HBM을 이 인터포저 위에 나란히 올려놓으면 두 칩이 인터포저 안의 미세한 배선으로 직접 연결된다. 거리가 짧고 배선이 가늘고 개수가 많다. 그래서 한 번에 1024개의 데이터 비트(bit)가 동시에 흐를 수 있다. 이게 HBM 이름이 의미하는 '하이 밴드위스'(High Bandwidth)의 출처다. 칩들은 평면(2D)으로 놓이지만 그 아래 인터포저라는 별도의 차원이 추가됐기 때문에 2.5D라 불리게 된 것이다.
HBM의 모든 세대(HBM, HBM2, HBM3, HBM3E, HBM4)는 지금까지 모두 2.5D 구조를 썼다. 올해 출시될 엔비디아의 루빈까지 전부 2.5D다.
지금 반도체업계가 개발 중인 것은 3D 구조. 'HBM-on-GPU'라는 말 그대로 HBM을 GPU 위에 쌓아올리는 방식이다.
독자들의 PICK!
기존 2.5D 패키징이 넓은 땅(실리콘 인터포저) 위에 GPU와 HBM을 나란히 짓는 단지형 아파트였다면 3D 패키징은 GPU 코어 바로 위로 HBM을 쌓아올리는 '초고층 주상복합 마천루'다. 2.5D에서는 데이터를 주고받기 위해 인터포저라는 옆길을 거쳐야 했다. 3D는 위아래를 직접 뚫는 TSV(실리콘관통전극) 기술을 사용해 GPU와 HBM을 최단거리로 직결한다. 지연시간은 극한으로 줄어들고 한 번에 퍼나르는 데이터양은 폭발적으로 증가한다. 전력도 절감된다. 거리가 줄면 전자저항이 작아지기 때문이다. 전기 먹는 하마인 AI데이터센터 입장에선 구세주와 같다.
HBM이 위로 올라가면서 남게 된 옆자리에는 GPU 코어를 더 집어넣거나 아니면 칩 전체의 크기를 줄여 하나의 랙(rack)에 더 많은 AI 가속기를 꽂아넣을 수도 있다.
'CES 2026'과 'GTC 2026'에 참석한 엔비디아의 젠슨 황 CEO(최고경영자)는 2028년 파인만 아키텍처에 3D를 적층한 커스텀 HBM을 언급했다. HBM을 3D로 쌓아올리고 수만 개의 접점을 연결하는 패키징 기술을 기적이라고 표현하기도 했다. 실제 글로벌 반도체 거인들은 3D 설계를 상용화하기 위해 이미 천문학적인 돈을 쏟아부으며 기술전쟁을 치르고 있다.
대만 TSMC는 SoIC(System-on-Integrated-Chips)라는 3D 적층기술을 내세웠으며 애플과 AMD도 큰 관심을 보여왔다. 삼성전자도 3D 패키징 기술인 'SAINT-D'를 적극적으로 개발하고 있다. 미국의 인텔은 포베로스라는 자체 3D 패키징 기술을 내세운다.
◇문제는 반도체 발열…140도, 어떻게 잡나
3D 기술이 쉽지는 않다. 상용화를 가로막는 높은 벽은 바로 열이다. GPU는 데이터를 연산하며 어마어마한 열을 뿜어낸다. 그런데 HBM(D램)은 열에 극도로 취약해 온도가 85도를 넘으면 저장된 데이터가 날아가 버린다. 3D 방식은 가장 뜨거운 발열체인 GPU 바로 위에 열에 약한 HBM을 올려놓는 형태다.
벨기에 반도체 연구기관 IMEC는 지난해 12월8일 미국 샌프란시스코에서 열린 국제전자소자회의(IEDM)에서 3D 구조로 만든 GPU 표면온도가 141.7도까지 치솟아 칩이 녹아내릴 것이라고 지적했다. 그러나 온도를 70.8도까지 내릴 수 있다는 해결책도 제시했다.
칩 위쪽뿐 아니라 아래쪽에서도 동시에 열을 빼는 양면냉각이 제시된 답이다. 핵심은 칩과 외부 냉각시스템 사이에 끼어 있는 작은 금속판, 히트슬러그(Heat Slug)라고 불리는 금속부품이다. 칩에 히트슬러그를 붙여서 액침냉각 등 외부 냉각장치와 연결하면 열을 빠르게 내릴 수 있다는 것이다. 칩 하부에도 열을 빼는 보텀사이드 쿨링과 다양한 소재로 개발 중인 히트슬러그를 결합하면 시너지가 높다는 지적이다.
히트슬러그만 전문적으로 양산, 제조하는 상장기업은 미국에는 드물다. 인텔, AMD 같은 기업도 히트슬러그 구조를 설계하지만 제조는 한국, 일본, 중국 등 아시아 기업에 맡긴다. 하지만 히트슬러그의 성능을 끌어올리는 발열관리 밸류체인 기업은 꽤 있다.
열 순환구조는 '칩→히트슬러그→TIM(열 계면물질)→콜드플레이트→CDU(냉각수분배장치)→냉각수→열교환기→냉각탑→외부' 형태다. 미국은 콜드플레이트 다운스트림에 압도적 종목들이 포진해 있다. 4개 종목이 발열 밸류체인 80%를 커버하는데 △버티브(VRT) △모다인(MOD) △파커하니핀(PH) △마이크론(MU)이다.
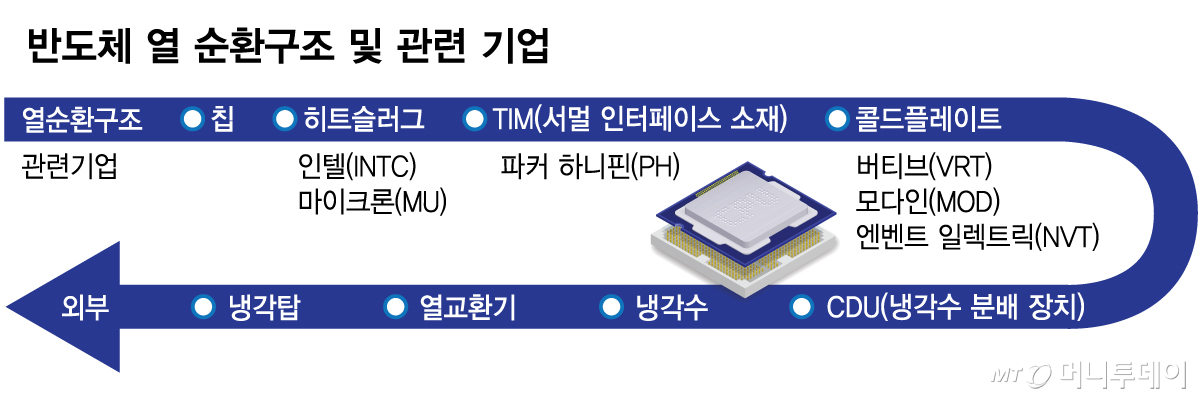
◇서플라이 체인에 마이크론-버티브-모다인 등 포진
히트슬러그에 가장 가까운 미국 상장사는 인텔(INTC)과 마이크론이다. 두 회사 모두 차세대 IHS(통합열분산기) 설계 IP(지식재산권)를 보유했다. 다만 인텔 자체는 파운드리(위탁생산) 사업의 불확실성이 너무 커서 IHS만 보고 투자하기는 부담스럽다.
마이크론은 IMEC가 강조한 보텀사이드 쿨링의 핵심기술을 지녔다. 실적도 좋아 2026회계연도 2분기(2025년 12월~2026년 2월) 마이크론의 EPS(주당순이익)는 예상치 8.79달러를 넘어선 12.20달러를 기록했다. 매출은 예상치 191억9000만달러를 24% 넘어선 238억6000만달러다. 5개 분기 연속 어닝서프라이즈(깜짝 실적)다. 마이크론의 경우 기존 반도체사업이 압도적으로 크지만 히트슬러그 기술개발에 성공한다면 반도체사업에도 막대한 영향을 준다.
히트슬러그와 콜드플레이트 사이를 메우는 소재는 TIM인데 파커하니핀이 대표기업으로 꼽힌다. 자회사 코메릭스가 TIM 전문사업부다. 2019년 로드코퍼레이션 인수로 첨단 접착제·TIM 포트폴리오를 확장했다. 하니웰은 AI데이터센터·5G(5세대 이동통신)·전기차향 커스텀 TIM이 주력인데 다만 TIM이 전체 매출에서 차지하는 비중이 작다. 3M은 서멀 관리 테이프와 갭필러를 공급하고 다우는 디스펜서블 서멀패드 같은 실리콘 기반 TIM이 강점이다.
히트슬러그 다운스트림에서 비중이 높은 콜드플레이트 사업을 하는 회사는 많은 편이다. 본격적으로 열을 흡수해 데이터센터 냉각시스템으로 전달하는 기업으로는 버티브가 1순위에 꼽힌다. 엔비디아 공식 파트너로 GB200 NVL72 레퍼런스 아키텍처를 공동개발했다. 차세대 루빈 아키텍처도 함께 설계 중인 것으로 알려졌다. 지난 3월 S&P500지수에 편입되면서 시장의 주류종목으로 자리잡았다.
올 1분기 매출은 26억5000만달러(약 3조8425억원)로 전년 동기 대비 30% 늘었다. 조정 영업이익은 64% 급증, 조정 EPS는 1.17달러를 기록했다. 2026년 가이던스도 최근 상향조정해 매출 전망치는 최대 140억달러(약 20조3000억원), 조정 EPS는 6.30~6.40달러 수준으로 3년치 일감을 이미 확보했음을 과시했다.
최근 주목받는 기업은 모다인이다. 시가총액은 상대적으로 작지만 성장률은 더 가파르다. AI데이터센터에 특화된 '에어데일 바이 모다인' 브랜드가 핵심이다. 데이터센터 매출이 폭증하고 있다. 모다인은 올 초 'TurboChill 3+MW' 칠러를 공개했다. AI데이터센터의 GPU 발열을 처리하는 대형 냉각장비다. 회사는 데이터센터 매출이 2026년 10억달러(1조4500억원)에서 2028년 20억달러(2조9000억원)로 증가할 것이라고 본다. 올해 20~25% 매출성장을 예상한다.
CDU·매니폴드·콜드플레이트를 자체 브랜드로 공급하는 엔벤트일렉트릭(NVT)도 주목할 만하다. 데이터센터 솔루션 라인업이 본격 가동단계다. 다만 버티브, 모다인 등은 모두 주가가 급등하며 냉각 인프라 관련한 실적이 밸류에이션에 어느 정도 반영됐다는 점이 부담스러운 부분이다.
